С момента появления первого коммерческого сканирующего электронного микроскопа в 1965 году, после 40 лет непрерывного совершенствования разрешение сканирующей электронной микроскопии увеличилось с 25 нм до первого до 0,01 нм. Большая часть сканирующей электронной микроскопии может сочетаться с рентгеновским спектрометром и рентгеновским энергетическим спектрометром, который стал всеобъемлющим анализом поверхностного микромира. Многофункциональный прибор для электронной микроскопии. Сканирующая электронная микроскопия (СЭМ) стала мощным инструментом, широко используемым в различных областях науки и промышленности. Сканирующая электронная микроскопия (СЭМ) широко используется во многих областях, таких как геология, биология, медицина, металлургия, механическая обработка, материалы, производство полупроводников и контроль керамики.
Сканирующая электронная микроскопия (СЭМ) играет чрезвычайно важную роль в области материалов. Он широко используется при изучении морфологии, состояния поверхности раздела, механизма повреждения и прогнозирования характеристик материалов для различных материалов. Сканирующая электронная микроскопия (СЭМ) может быть использована для непосредственного изучения дефектов кристаллов и процесса их производства. Он может наблюдать режим агрегации атомов в металлических материалах и их истинные границы. Также можно наблюдать режим движения границ при разных условиях. Он также может проверить повреждения и радиационные повреждения, вызванные кристаллом при обработке поверхности.
Принцип работы сканирующего электронного микроскопа
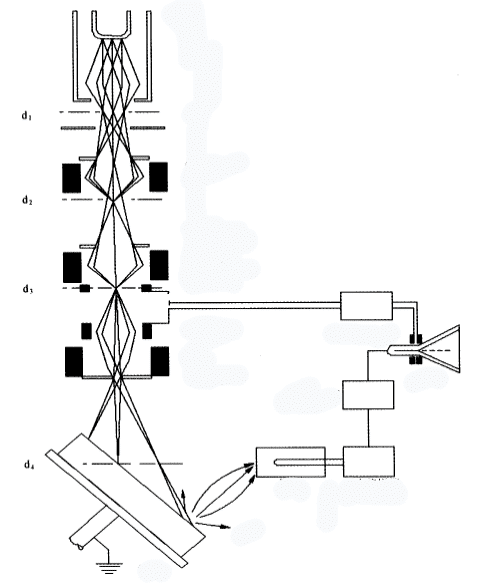
Принцип работы сканирующего электронного микроскопа показан в
Рис. 1 Принципиальная схема сканирующего электронного микроскопа
Сканирующий электронный микроскоп (СЭМ) состоит из электронных пучков, испускаемых из электронной пушки. Под действием ускоренного напряжения электронные лучи сходятся через систему магнитных линз, образуя электронную оптическую систему диаметром 5 нм. После двух или трех электромагнитных линз электронные пучки сходятся в тонкий электронный пучок, фокусирующийся на поверхности образца. Сканирующая катушка установлена на верхней стороне конечной линзы, под которой электронный луч сканируется на поверхности образца. Благодаря взаимодействию между электронными пучками высокой энергии и материалами образцов генерируется различная информация: вторичные электроны, электроны с обратным отражением, электроны поглощения, рентгеновские лучи, оже-электроны, катодолюминесценция и электроны пропускания. Эти сигналы принимаются соответствующим приемником, усиливаются и отправляются на затвор кинескопа для модуляции яркости кинескопа. Поскольку ток на сканирующей катушке соответствует яркости кинескопа, то есть когда электронный луч попадает в точку на образце, на экране кинескопа появляется яркое пятно. Таким образом, сканирующая электронная микроскопия (SEM) использует метод точечной визуализации для пропорционального преобразования различных характеристик поверхности образца в видеосигналы, чтобы завершить кадр изображений, чтобы можно было наблюдать различные характерные изображения поверхность образца на люминесцентном экране.
Приложение сканирующего электронного микроскопа
Сканирующая электронная микроскопия (СЭМ) обычно оснащена спектрометром или энергетическим спектрометром. Спектрометр использует уравнение Брэгга 2dsin (= (), чтобы возбудить рентгеновские лучи от образца и отделить их соответствующими кристаллами. Характерные рентгеновские лучи с различными длинами волн будут иметь различные углы дифракции 2 (). Спектрометр является мощным инструментом для Анализ микросферного компонента. Разрешение спектрометра по длине волны очень высокое, но область его применения ограничена из-за низкого уровня использования рентгеновского излучения. Энергетический спектрометр - это метод элементного анализа, основанный на разности энергий рентгеновского кванта Для элемента, когда рентгеновский квант проходит от основного квантового числа желудка N1 к главному квантовому числу n2, существует удельная энергия (= (n1- (n2)). Энергодисперсионный спектрометр имеет высокое разрешение и высокую скорость анализа , но его способность к разрешению плохая. Часто есть перекрывающиеся линии, и точность элементного анализа для низкого содержания очень низка.
Спектрометры и энергетические спектрометры могут не заменять друг друга, а дополнять друг друга.
Применение сканирующего электронного микроскопа в материаловедении
Наблюдение морфологии поверхности материалов
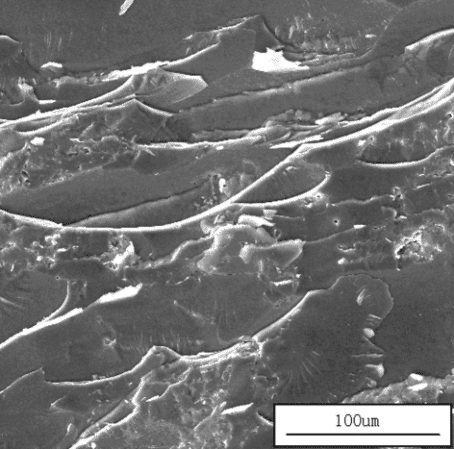
РИСУНОК 1 - СЭМ-МОРФОЛОГИЯ ГОРЯЧЕЙ РУЧНОЙ ПОВЕРХНОСТИ ОЧИЩАЮЩЕЙ СТОРОНЫ Mg
Морфология СЭМ поверхности отслаивания на стороне магния горячекатаного плакированного Al-Mg листа (температура прокатки 400 C, скорость восстановления 45%) показана на рисунке 1. Из графика мы можем ясно видеть, что существует множество разрывных кромок и платформ на поверхности отслаивания, а на разрывной платформе много маленьких радиальных полосок и ямочек.
Вторая фаза наблюдения материала

Рисунок 2. Мощная микроструктура магниевого сплава AZ31 от SEM.
Из рис. 2 хорошо видно, что размер второй фазы Mg17Al12 после фрагментации составляет около 4 мкм, а вблизи «объемного» Mg17Al12 имеется множество дисперсных мелких частиц размером около 0,5 мкм. Это вторая фаза Mg17Al12, выделенная из пересыщенного твердого раствора основания a-Mg в процессе охлаждения после горячей прокатки, демонстрирующая мелкость этого морфологического распределения. Двухфазный Mg17Al12 может эффективно ингибировать движение дислокаций, повышать прочность материала и играть роль дисперсионного упрочнения, но не будет значительно снижать пластичность магниевого сплава AZ31.
Наблюдение за материальным интерфейсом

Рисунок 3 Mg / Al прокатки интерфейсной линии сканирования [1]
Фиг.3 представляет собой линейное сканирующее изображение интерфейса прокатки композитного Mg / Al. Из графика видно, что можно получить линию сканирования через интерфейс между Mg и Al. Со стороны Al содержание Mg низкое, а со стороны Mg Al почти равен нулю. Однако на границе раздела происходит около половины Mg и Al, что указывает на то, что диффузия происходит на границе раздела, образуя Mg и Al. Диффузионный слой.
Наблюдение за разрушением материала

(а) литье

(б) горячекатаный
Рисунок 4. Морфология разрушения при растяжении магниевого сплава AZ31.
СЭМ-сканирование морфологии разрушения при растяжении отлитого магниевого сплава AZ31 показано на фиг. 3-6. Из рис. 4 (а) видно, что имеются очевидные платформы для трещин при расщеплении и несколько ямочек в конечной точке разрыва, которые в основном представляют собой квазиразрывную трещину с низкой пластичностью. Это связано с тем, что на границе зерен литого магниевого сплава AZ31 имеется большая хрупкая вторая фаза Mg17Al12, которая легко растрескивается и образует источник трещин при деформации растяжения. Морфология разрушения горячекатаного магниевого сплава AZ31 демонстрирует очевидное явление образования шей. Как показано на рисунке 4 (b), морфология макроразрушения магниевого сплава AZ31 показывает морфологию вязкого разрушения с размером ямки в диапазоне от 5 до 20 мкм.
Заключительные замечания
Сканирующая электронная микроскопия (СЭМ) широко используется в материаловедении. Его можно использовать не только в вышеуказанных аспектах материаловедения, но и при усталостном разрушении металлов и морфологическом наблюдении за примесями. Будучи студентом, изучающим материалы, мы должны понимать принцип работы и применение сканирующей электронной микроскопии и в полной мере использовать инструмент сканирующей электронной микроскопии в наших научных исследованиях для проведения всестороннего и тщательного изучения материалов.







